Toward Successful Integration of Porous Low-k Materials: Strategies Addressing Plasma Damage
Résumé
The increasing sensitivity of porous low dielectric constant materials to process damage constitutes a major roadblock to their implementation in back-end-of-the-line (BEOL) wiring structures for advanced technology nodes. In the early 2000s and in anticipation to future low-k related integration challenges, the semiconductor industry started to investigate the possibility to repair or prevent this damage. It is remarkable that the most disruptive solutions proposed today are inspired from the work initiated more than 10 years ago. In this review we first describe the accepted mechanisms for plasma damage, followed by a quick summary of the methods used to quantify its extent on both blanket films and patterned structures. We then report on the past and current strategies developed to mitigate the plasma damage of porous, low-k materials during damascene integration processes.
Fichier principal
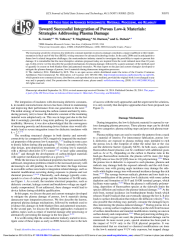 Lionti - ECS J. Solid State Sci. Technol.-2015-Lionti-N3071-83.pdf (935.7 Ko)
Télécharger le fichier
Lionti - ECS J. Solid State Sci. Technol.-2015-Lionti-N3071-83.pdf (935.7 Ko)
Télécharger le fichier
Origine : Publication financée par une institution