Temperature impact (up to 200°C) on performance and reliability of HfO2-based RRAMs
Résumé
This paper provides an overview of the temperature impact (up to 200 °C) on the electrical behavior of oxide-based RRAM, during forming, low-field resistance reading, SET/RESET, disturb, data retention and endurance. HfO 2-RRAM devices (in a 1T1R configuration) integrated in an advanced 65 nm technology are studied for this aim. We show that forming operation is strongly activated in temperature (i.e.-0.5 V per hundred Celsius degree), being much less for SET and RESET voltages (i.e. <-0.05 V per hundred Celsius degree); disturb of HRS at fixed voltage showed to be independent of temperature; endurance up to 3.10 6 cycles, with optimized set of stress parameters showed no significant variation; data retention at 150 °C up to 68 days showed stable programming window, after different initial programming algorithms.
Fichier principal
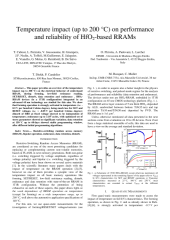 Caout.2013.IMW.Temperature_impact_on_performance_and_reliability_of_HfO2_based_RRAMs.pdf (1.55 Mo)
Télécharger le fichier
Caout.2013.IMW.Temperature_impact_on_performance_and_reliability_of_HfO2_based_RRAMs.pdf (1.55 Mo)
Télécharger le fichier
Origine : Fichiers produits par l'(les) auteur(s)
Loading...